Advanced Cleaning SolutionsPost Cu/Low-k CMP Cleaning Solution, "MCX-SDR4"
Mitsubishi Chemical CorporationDuring the post CMP cleaning process in semiconductor manufacturing, it is important to remove organic residues and particles on Cu wires and Low-k films without damaging the substrate. Our product, MCX-SDR4, is a high-efficiency cleaning solution suited for semiconductor industries.
Characteristics:
- High efficiency particle removal
- Removes organic residues effectively
- Limits galvanic corrosion on Cu wire
- Limits Low-k damage
- Improves Low-k wetting properties
Characteristics
[Close]
After polishing Cu/Low-k film by CMP, the film is left with inorganic and organic residues. Therefore, the following properties are required in order to achieve high purity by post CMP cleaning.
- 1.Particle removal
- 2.Removal of organic residues
- 3.Removal of metal residues
- 4.Limit Cu corrosion
- 5.Limit side reactions
- 6.Hydrophilic treatment on substrate
Our product meets those requirements and provides high performance for the semiconductor industry.
MCX-SDR4
- 1.Surfactant improves wetting of hydrophobic surfaces
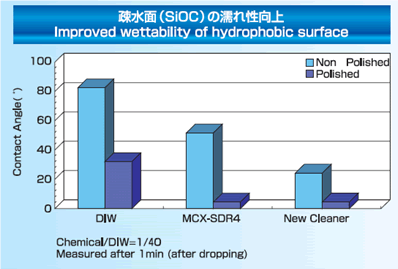
- 2.Limits Cu and Low-k surface damage
- 3.Removes organic residues generated by slurry
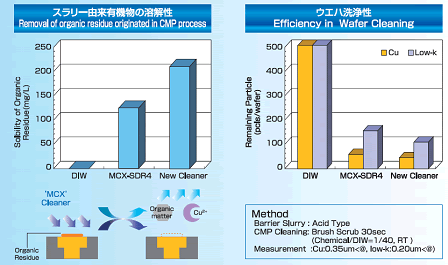
- 4.Effectively removes particles and metal residues
- 5.Stable process performance
By having these properties, our product achieves high-efficiency cleaning on Cu wires and on hydrophobic Low-k surfaces. We are continuing to develop and improve advanced cleaning solutions to support the advancing miniaturization of semiconductor processors.
Applications
[Close]
Cleaning after Cu CMP (slurry polishing) process
Inquiries Concerning Products
View the products of Semiconductor Materials Dept., Mitsubishi Chemical[Open in a new window]



